

三星HBM4计划2025年首次亮相:将有16层堆叠,改用3D封装 - 超能网
source link: https://www.expreview.com/93361.html
Go to the source link to view the article. You can view the picture content, updated content and better typesetting reading experience. If the link is broken, please click the button below to view the snapshot at that time.
三星HBM4计划2025年首次亮相将有16层堆叠,改用3D封装
吕嘉俭发布于 2024-4-18 17:36
本文约 660 字、3 张图表,需 2 分钟阅读
近年来,人工智能(AI)、高性能计算(HPC)和PC一直在推动高性能DRAM产品的研发,市场对HBM类DRAM的需求也在迅速增长,各大厂商也加大了这方面的投入。目前HBM市场主要由三星、SK海力士和美光三家存储器制造商占有,根据统计机构的数据,SK海力士占据了50%的市场份额,三星以40%紧随其后,剩下的10%属于美光。

今天三星发表了一篇采访文章,受访对象是三星电子产品规划办公室高级副总裁Kim Kyung-ryun和三星电子HBM的DRAM开发办公室高级副总裁Jae-Yoon Yoon,其中介绍了三星在HBM的开发情况。
三星再次重申了HBM4正在开发当中,将于2025年首次亮相。不过三星并没有公布其HBM4的代号,之前的HBM3和HBM3E的代号分别是“Icebolt”和“Shinebolt”。目前三星提供的最顶级HBM产品是今年2月推出的12层堆叠HBM3E,拥有36GB容量,数据传输速率达到了9.8 Gbps,提供了高达1280GB/s的带宽,比起之前的8层堆栈产品均提高了50%,是迄今为止带宽和容量最高的HBM产品。

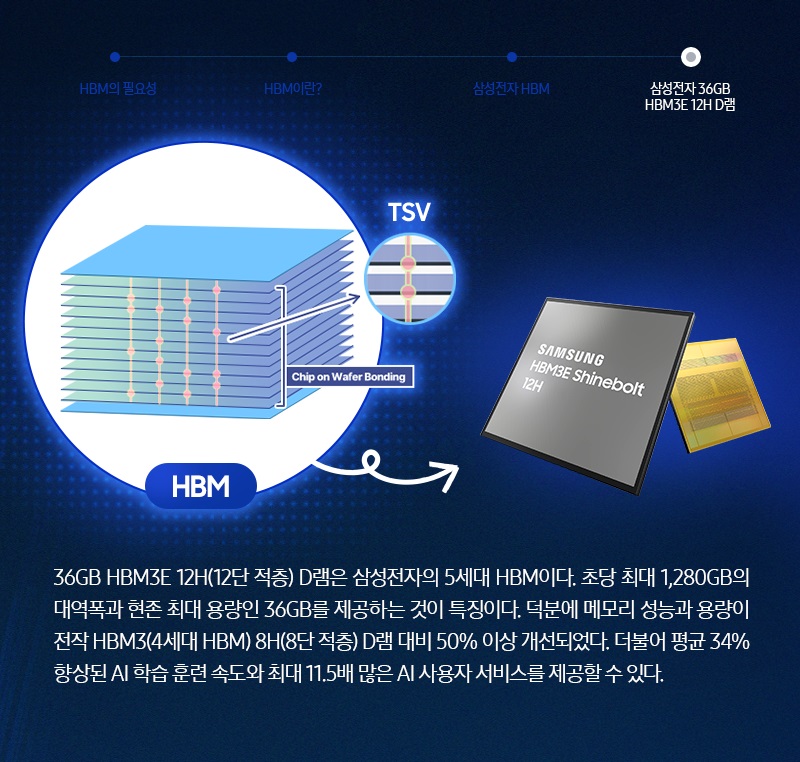
据三星介绍,随着硬件的多功能性变得更加重要,HBM4在设计上也会针对不用的服务应用进行优化,计划通过统一核心芯片、多样化封装和基础芯片(比如8/12/16层堆叠)来应对。为了解决功耗墙的问题,首个创新将从使用逻辑工艺的基础芯片开始,随后是第二个创新,从当前2.5D HBM逐步发展到3D HBM,最后预计会出现第三次创新,比如HBM-PIM,也就是具备计算功能的内存半导体技术,这点之前三星已经有过介绍。
之前还有传言称,下一代HBM4在设计会有重大的变化,内存堆栈将采用2048位接口,三星还会引入针对高温热特性优化的非导电粘合膜(NCF)组装技术和混合键合(HCB)技术。
Recommend
About Joyk
Aggregate valuable and interesting links.
Joyk means Joy of geeK